Институт физики микроструктур РАН
- филиал Федерального государственного бюджетного научного учреждения "Федеральный исследовательский центр Институт прикладной физики им. А.В. Гапонова-Грехова Российской академии наук" (ИФМ РАН)
|
Низкобарьерный диод Мотта на основе GaN/AlGaN
Впервые продемонстрировано снижение эффективной высоты барьера Мотта в диодной гетероструктуре металл/AlGaN/GaN за счет поляризационно-индуцированного d-легирования гетероперехода. Эффективная высота барьера контролируется изменением толщины и состава слоя AlGaN и работой выхода металла барьерного контакта. Изготовлены низкобарьерные диоды Мотта Ti/AlGaN/GaN, демонстрирующие высокие значения ампер-ваттной чувствительности (9 А/Вт) при малой удельной величине дифференциального сопротивления (4´10−4 Wxсм2) при нулевом смещении.
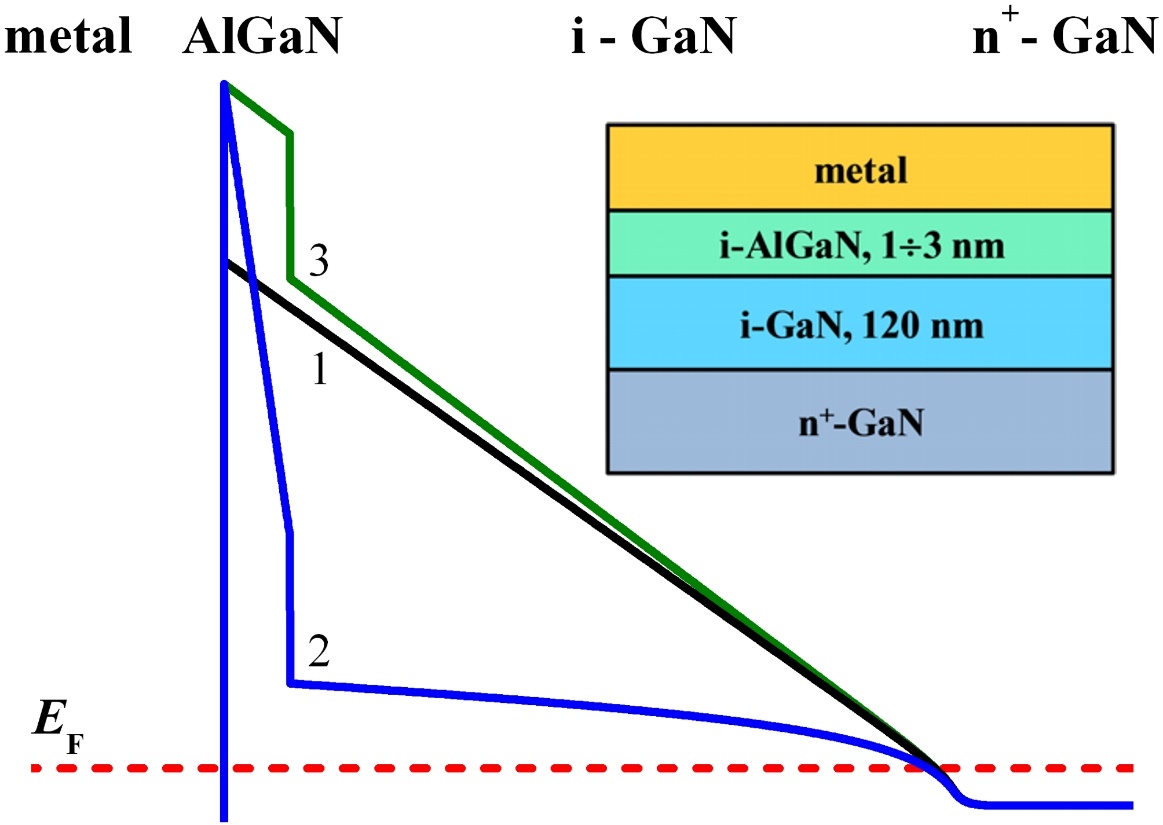
|
Координатные зависимости положения дна зоны проводимости в диодных гетероструктурах (схематично) демонстрируют влияние поляризационного заряда, расположенного в плоскости гетерограницы AlGaN/GaN, на форму потенциального барьера: обычный диод Мотта металл/GaN — кривая 1; низкобарьерная диодная гетероструктура металл/AlGaN/GaN — кривая 2; такая же гетероструктура металл/AlGaN/GaN, но без учета поляризационных свойств — кривая 3. На вставке показана схема слоев в низкобарьерной диодной гетероструктуре. |
Авторы:
Н.В.Востоков, М. Н. Дроздов, О. И. Хрыкин, П. А. Юнин, С. А. Краев, В. И. Шашкин — ИФМ РАН.
Публикации:
N.V. Vostokov, M.N. Drozdov, O.I. Khrykin, P.A. Yunin, and V.I. Shashkin. Low-barrier Mott diodes with near-surface polarization-induced δ-doping. Appl. Phys. Lett., V. 116, No. 1, 013505 (2020).

